BondFlow™ 접착제
BondFlow™는 혁신적인 새로운 다이 접착제입니다. 웨이퍼 후면과 웨이퍼 절단에 앞서 B-stage에도 적용할 수 있습니다. 이러한 후면 다이 접착제는 온도 250°C, 압력 50 ~ 100 psi 하에서 불과 2초 만에 경화됩니다.
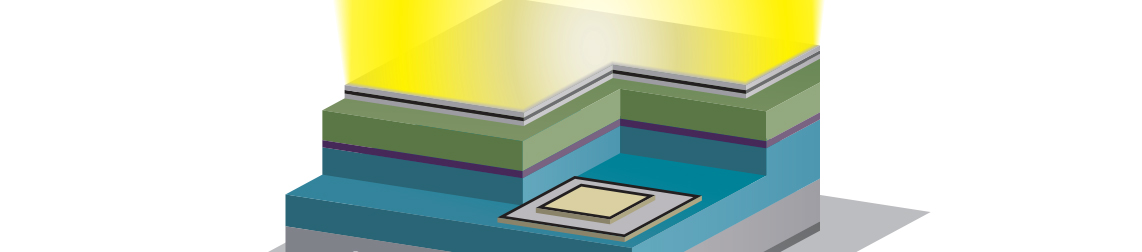
BondFlow™는 혁신적인 새로운 다이 접착제입니다. 웨이퍼 후면과 웨이퍼 절단에 앞서 B-stage에도 적용할 수 있습니다. 이러한 후면 다이 접착제는 온도 250°C, 압력 50 ~ 100 psi 하에서 불과 2초 만에 경화됩니다.
BondFlow™의 장점: Materion만의 유일무이한 접착제는 다양한 표면에 스핀 코팅 또는 프린팅으로 처리될 수 있습니다. 이는 매끈한 세라믹, 규산염(창문) 유리, CVD 다이아몬드 및 Al, Au, Ni, Si, GaAs 등에 잘 접착됩니다.
클릭하여 BondFlow™에 관한 정보를 확인하세요. 마이크로 전자 포장을 지원하는 접착제 및 기타 제품