BONDFLOWTM 粘合剂
BondFlow™ 是一种颠覆性的新模贴粘合剂。它可以粘到晶圆的背面,并在切割前进入半熔阶段。这种背面模贴粘合剂在温度为 250°C、压力为 50 – 100 psi 时仅需 2 秒即可固化。
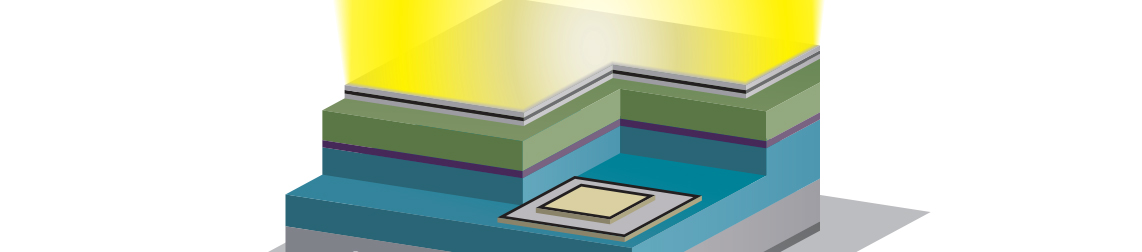
BondFlow™ 是一种颠覆性的新模贴粘合剂。它可以粘到晶圆的背面,并在切割前进入半熔阶段。这种背面模贴粘合剂在温度为 250°C、压力为 50 – 100 psi 时仅需 2 秒即可固化。
BondFlowTM的优势:我们独特的粘合剂,可以旋涂或印在各种表面上它与裸陶瓷、硅酸盐(窗户)玻璃、CVD 金刚石和铝、金、镍、硅和砷化镓都能很好地粘合。
单击了解有关 BondflowTM 粘合剂和支持微电子封装的其他产品的更多信息。